Что же такое новая технология безмаскового экспонирования MLE™ (Maskless Exposure) компании EV Group? Это переход от технологии, основанной на использовании фотошаблонов, к технологии цифровой литографии.
Какие требования предъявляет современное крупносерийное производство микроэлектроники к литографическим системам?
Попробуем разобраться в этом. Новые требованиям к производительности и гибкости электронных устройств ставят задачи по модификации серийного производства от традиционной контактной фотолитографии с использованием масок-фотошаблнов к цифровой литография — безмасковой, которая особенно необходима для процессов гетерогенной интеграции и «продвинутой упаковки» (advance packaging). Тип микроэлектронного изделия — системы на кристалле (СнК) (system-on-chip) сегодня переходит от решений, использующих монолитные интегральные схемы (МИС), к модульным системам в упаковке — чипсетам и функциональным блокам. Следовательно, растет спрос на масштабируемую и универсальную фотолитографию, которая позволит обеспечить возможности системной интеграции, «продвинутой упаковки» и сложных межсоединений. Чтобы соответствовать этому новому веянию микроэлектронной отрасли, современные системы для крупносерийного производства должны уметь быстро интегрировать новые функциональные элементы в системы с «продвинутой упаковкой». Промышленность с большими объемами производства должна выходить за рамки консервативного проектирования изделий (кристаллов, МИС, сборок и т.д.) и войти в новую эру технологий цифровой литографии.
Компания EV Group¹ разработала новую технологию безмаскового экспонирования MLE™ (Maskless Exposure). Технология позволит удовлетворить поставленные требования к гибкости проектирования новых изделий с минимальным циклом разработки и использовать ее в микроэлектронном мире крупносерийного производства. MLE™ должна устранить все трудности и сократить затраты, связанные с использованием маски — фотошаблона, устранить разрыв между универсальностью машин (медленное производство) и быстрым производством (не гибкое производство). MLE™ обеспечит решение, которое может быть масштабируемым и одновременно позволит проектировать на уровне кристалла и пластины, поддерживая как традиционные, так и новые материалы, а также обеспечит высокую скорость адаптации и высокую надежность с многоуровневым резервированием для повышения доходности и снижения стоимости владения.
Новая технология отвечает всем критическим требованиям процессов фотолитографии не только в процессах «продвинутой упаковки», но также для МЭМС-технологий, биомедицины и производства печатных плат.
С какими новыми проблемами столкнется литографический процесс для «продвинутой упаковки» и гетерогенной интеграции?
Поскольку гетерогенная интеграция становится растущей движущей силой в разработке и внедрении полупроводниковой промышленности, рынки «продвинутой упаковки», МЭМС и печатных плат серьезно ужесточают требования к процессам фотолитографии.
Требования минимального разрешения для слоев перераспределения (RDL) и межсоединений (interposers) в «продвинутой упаковке», с масштабированием размеров и постоянным уплотнением структур — линия/пробел (Line/Space), становятся все более строгими. В некоторых случаях они приближаются или превышают два микрона, при этом изменение положения кристалла на подложке/пластине и использование экономически эффективных органических подложек требуют все большей гибкости при их структурировании. Требования растут и к более высокой точности совмещения и наложения слоев, а также к высокой глубине фокуса в вертикальной структуре с боковыми стенками.
Новые требования, такие как минимизация искажения рисунка, минимизация сдвига (смещения) кристалла из-за искривления пластины (если речь идет об упаковке на уровне пластины (WLP)), поддержка толстых и тонких фоторезистов — это лишьнекоторые из критериев для существующих и будущих передовых систем литографии. В Таблице 1 приведены основные требования к литографии для различных сфер микроэлектроники.
Таблица 1 Основные требования к литографии для различных сфер микроэлектроники
|
«Продвинутая упаковка» |
МЭМС |
Биомедицина |
Печатные платы с высокой плотностью рисунка |
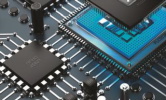
|

|

|

|
|
|
|
|
|
Немного об основных принципах экспонирования и ключевых аспектах безмасковой литографии
Фундаментальные принципы различных видов экспонирования представлены в Таблице 2.
Таблица 2 Фундаментальные принципы экспонирования
|
Метод экспонирования |
Система совмещения и экспонирования с зазором |
Степпер — проекционная литография |
Безмасковое экспонирование MLE™ |
Прямое лазерное экспонирование |
 |
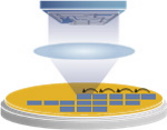 |
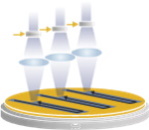
|
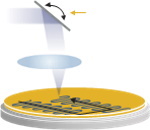
|
|
|
Размер поля экспонирования |
Все поле |
Размер единичной структуры ограничен (до 50 мм x 25 мм) |
Кластерная система пишущих голов |
Одиночные лазерные точки |
|
Длина волны экспонирования |
Широкополосное (g, h, |
|
Многоволновая оптика |
Одна длина волны |
|
Разрешение линия/пробел |
> 3 мкк |
> 1,5 мкм |
< 2 мкм |
До 600 нм в зависимости от объектива и производительности |
Ключевые аспекты MLETM
- Динамическое структурирование фоторезиста с полным разрешением и без сшивки.
- Разрешение линия/пробел лучше, чем 2 мкм в любом произвольном направлении.
- Свобода дизайна и конфиденциальность данных благодаря созданию структур в цифровом виде.
- Индивидуальные дополнения к каждому кристаллу (серийные номера, ключи шифрования и т. д.).
- Компенсация адаптивной регистрации на уровне пластин.
- Деформация основания не оказывает влияния на процесс (возможность использовать толстые пластины, стекло или органические материалы).
- Интеллектуальная и гибкая инфраструктура обработки для процесса цифровой литографии.
- Технология, не использующая расходные материалы.
Немного о проблемах и трудностях, возникающих на литографическом пути
Основным элементом каждого процесса литографии является модуль экспонирования, который определяет основные характеристики и производительность той или иной литографической технологии. В настоящее время на рынке существует несколько распространенных методов экспонирования. В случае совмещения фотошаблона и пластины рисунок непосредственно экспонируется на подложку через фотошаблон (маску), которая находится в непосредственной близости от светочувствительной пластины с фоторезистивным покрытием. Минимальный размер структуры определяется зазором между маской и пластиной. Близость маски к поверхности фоторезиста позволяет получить меньшие структуры, однако при слишком близком контакте происходит загрязнение маски, что приводит к уменьшению выхода годных. Несмотря на то, что минимальное разрешение на серийном производстве ограничено несколькими микронами, технология совмещения фотошаблона с пластиной и последующего экспонирования обеспечивают решение для создания недорогих и высокопроизводительных систем, особенно когда требуются высокая доза облучения и работа с толстыми фоторезистами (более 100 мкм) или процессами WLP.
Чтобы преодолеть некоторые из этих трудностей при формировании рисунков меньшего размера без загрязнения маски используют степперы, в которых применяется проекционная оптика между маской и пластиной. Тем не менее, экспонирование происходит последовательно или пошагово с сильным ускорением между экспонированиями, поскольку оптическая конструкция сложных объективов и размер поля экспонирования ограничены.
Системы совмещения и экспонирования, также как и степперы, используют фотошаблоны, где в дополнение к вышеупомянутым ограничениям появляются еще и связанные с ними затраты, и представляют собой серьезные дополнительные затраты для всего процесса формирования рисунка. Одно из решений, позволяющее исключить стоимость фотошаблона, — это технология прямого лазерного экспонирования с использованием отдельных или нескольких лазерных лучей, которые последовательно экспонируют небольшие геометрические элементы. Даже принимая во внимание преимущества метода прямого экспонирования, последовательный характер воздействия приводит к значительным затратам из-за очень низкой производительности.
Технология MLE™ позволяет экспонировать одну или несколько широких полос в режиме параллельного сканирования и использовать пластины любого размера вплоть до больших панелей благодаря плотно интегрированной кластерной конфигурации пишущей головы. Технология поддерживает все имеющиеся в микроэлектронной промышленности фоторезисты, так как в ее основе лежит использование мощного ультрафиолетового источника с несколькими длинами волн. Производительность такой системы не зависит от сложности, разрешения получаемых структур и типа используемого фоторезиста. MLE™ дополняет линейку существующих литографических систем компании EV Group, опираясь на новые мировые тенденции и задачи, когда другие подходы сталкиваются с различными ограничениями, масштабируемостью и стоимостью владения.
Что же даст переход на новую схему литографии?
Ответ на этот вопрос прост — гибкость, масштабируемость и меньшую стоимость владения по сравнению с существующими методами литографии, используемыми в крупносерийном производстве.
Технология MLE™ расширяет границы существующих систем литографии, обеспечивает высокое разрешение (<2 мкм линия/пробел), безмасштабное экспонирование всей поверхности подложки с высокой производительностью и низкой стоимостью владения. Позволяет масштабировать структуры и гибко менять свою конфигурацию в соответствии с потребностями пользователя, добавляя или удаляя пишущие головы УФ-облучения, что облегчает и обеспечивает быстрый переход из режима НИОКР в режим крупносерийного производства. Дает возможност оптимизировать роизводительность и обеспечивает превосходную адаптивность к различным размерам структур и материалам подложек, поэтому идеально подходит для работы с широчайшей номенклатурой подложек в микроэлектронном производстве от небольших кремниевых или других полупроводниковых пластин группы AIIIBV до панелей больших размеров. MLE™ обеспечивает одинаковую производительность формирования рисунка независимо от типа фоторезиста благодаря гибкому и масштабируемому мощному УФ-лазерному источнику с различными вариантами воздействия по длине волны. Внешний вид системы EVG MLETM показан на рис 2.
Технология MLE™ устраняет проблему постоянного увеличения стоимости фотошаблонов для различных конструкций чипов и поддержания их количества, необходимого для обеспечения непрерывного серийного производства, что составляет значительную часть общих затрат на разработку и производство. Снижение влияния изменения рисунка, с точки зрения размеров подложки и разнообразия материалов, на время выхода на рынок является еще одним критерием растущего спроса в серверной литографии. Технология MLE™ — это масштабируемый подход, который дает возможность создавать структуры любой формы на любой подложке. Данная технология использует кластерные многоволновые лазерные источники света, работающие на длинах волн 375 и/или 405 нм, что позволяет структурировать как тонкие, так и толстые фоторезисты, как позитивные, так и негативные, различные полиимиды, сухие пленочные резисты и даже применять данную технологию в производстве печатных плат. Примеры получаемых структур показаны на рис
Помимо трудностей, связанных с использованием фотошаблонов, современные технологии, основанные на их использовании, сталкиваются с проблемами, связанными с деформациями подложки и поэтому имеют ограничения по применению. В отличие от них технология MLE™ способна адаптироваться к высоким нагрузкам на подложку, изгибу и деформации благодаря встроенному динамическому выравниванию. Параллельно с этим технология MLE™ позволяет выполнять цифровую/двоичную компоновку уровня подложки в реальном времени и структур индивидуальной компоновки кристаллов одновременно. Кроме того, программируется уровень дозы УФ-излучения во время процесса формирования рисунка, поэтому можно обрабатывать структуры с различной толщиной фоторезиста. Эта исключительная особенность позволяет изготавливать сложные трехмерные многоуровневые схемы, применимые в будущих МЭМС, новых фотонных устройствах или микрооптических элементах (преломляющих, дифракционных). Получаемая структура может быть сохранена в многочисленных стандартных отраслевых форматах векторных файлов (например, GDSII, Gerber, OASIS, ODB ++ или BMP). Векторный макет с любой заданной сложностью шаблона обрабатывается в течение нескольких секунд и сохраняется в растровом формате. В результате ни тип фоторезиста, ни уровень дозы облучения, ни какая-либо конкретная сложность конструкции не влияют на скорость процесса формирования рисунка.
Что же нас ждет на пути к новой цифровой инфраструктуре?
Цель новой технологии безмаскового экспонирования EVG MLE™ состоит не только в том, чтобы вывести на рынок новый инструмент для литографии, но и в том, чтобы устранить тенденцию к интеллектуальной и гибкой цифровой обработке в полупроводниковой промышленности, обеспечивая при этом уникальную масштабируемость без использования фотошаблонов. Технология позволяет увеличить производительность и сократить расходы.
Использование этой современной технологии экспонирования также решает проблемы, обусловленные использованием новых материалов или гибких подложек, с которыми сталкиваются новые рынки. Практически неограниченная гибкость проектирования, привносимая технологией MLE™ в нынешнюю консервативную среду, открывает пространство для новых инноваций, помогает сократить циклы разработки и в то же время ликвидировать разрыв между НИОКР и крупносерийным производством, сделав одну и ту же технологию доступной для обеих областей.
В статье использованы материалы с сайта компании EV Group https://www.evgroup.com.
На высококонкурентном мировом рынке полупроводниковой промышленности гибкость производства, масштабируемость, затраты на разработку и эксплуатацию являются чрезвычайно важными факторами для сокращения времени выхода на рынок, что важно для удержания и расширения доли рынка. Таким образом, новая цифровая инфраструктура технологии EVG MLETM позволяет динамически обновлять устройства, сохраняя при этом расходы на разумном уровне.
12 ноября 2019 года на международных выставках Productronica 2019 и SEMICON Europa 2019 в Мюнхене, Германия, компания EV Group была признана ведущим поставщиком оборудования для бондинга пластин и процессов литографии для рынков MEMS, нанотехнологий и полупроводников, а также получила награду от Global SMT Packaging за лучший продукт в Европе и революционную технологию безмаскового экспонирования MLE™.
EV Group была удостоена этой чести среди избранных групп компаний на церемонии награждения, где были представлены самые последние инновационные продукты и технологии, успешно внедренные в производство электроники за последние 12 месяцев.
Подписывайтесь на наш канал на Яндекс.Дзен
¹EV Group, Австрия – партнер Остек-ЭК в области литографических процессов уже более 15 лет, https://www.evgroup.com