193-нм DUV-литография — процесс высокоточного переноса микроэлектронных структур на кремниевую подложку с использованием глубокого ультрафиолетового излучения (193 нм) на основе лазера ArF (фторид аргона). Система работает по принципу step-and-scan (шаг-сканирование), при котором пластина последовательно позиционируется и сканируется лучом излучения для экспонирования фоторезиста через маску. Этот процесс обеспечивает достижение разрешения 90 нм и позволяет получать структуры при технологических нормах производства 90-нм интегральных схем с высокой надежностью и минимальной погрешностью передачи рисунка.
PAS5500/1150C — флагманская 193-нм step-and-scan система для массового производства микроэлектронных структур. Оборудование построено на модульной платформе PAS 5500, ставшей революционной в промышленности благодаря своей гибкости и производительности. Система использует передовую оптику Carl Zeiss Starlith 1150 с числовой апертурой 0,75 NA и лазерный источник ArF с частотой повторения 2 кГц мощностью 10 Вт. Эта комбинация обеспечивает оптимальное качество изображения и контролируемую дозировку при каждой экспозиции, что критически важно для получения воспроизводимых результатов при массовом производстве.
Инновационные технологии включают систему выравнивания ATHENA с автоматической прецизионной юстировкой маски на длине волны экспонирования (193 нм, «синий» свет), что исключает необходимость в калибровке длины волны. Механизм выравнивания и удержания пластины обеспечивает точность позиционирования менее 20 нм между слоями, а система активного контроля фокуса и наклона поддерживает оптимальное расстояние между объективом и пластиной, максимизируя качество экспонирования по всей поверхности, включая края пластины. Внедрение двухстадийного сканирующего механизма позволяет осуществлять параллельное экспонирование одной пластины и выравнивание следующей, практически исключая времена простоя и обеспечивая непрерывное производство.
Особенности
- Разрешение нового степпера: 90 нм
- Разрешение восстановленного степпера: 150 нм
- Источник излучения: ArF — 193 нм
- Точность наложения слоев: ≤ 20 нм
- Размер фотошаблона: 6″
- Уменьшение размера с фотошаблона: 4:1
- Возможность работать с пластинами 6″ и 8″
- Размер кадра экспонирования: 26×33 мм
- Производительность: ≥ 135 пл./час (8″)



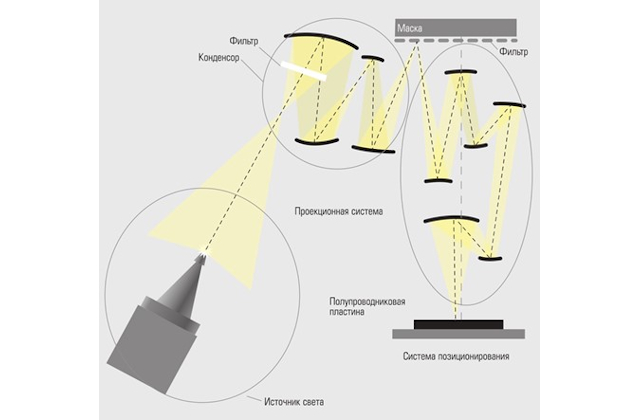
_1.jpg)