

ET-PME – установка плазмохимического травления фотошаблонов. Оптимизированная конструкция камеры позволяет точно контролировать получаемые критические размеры (CD), формируемые на фотошаблоне. Подходит для фотошаблонов различных размеров.
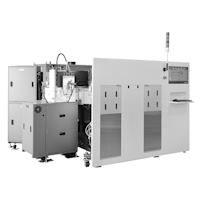
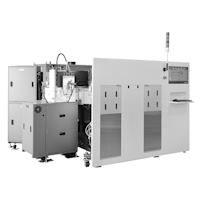
Система Plasma-E+ разработана для проведения плазмохимического травления различных слоев, таких как: оксид и нитрид кремния, фоторезистивные слои и другие полимерные материалы, Si, SiC, поликремний, металлы. Может применяться при производстве интегральных схем, МЭМС, силовой электроники, а также при работе с полупроводниковыми соединениями группы А3В5. Конфигурация процессных модулей зависит от типа необходимого процесса травления, её выбирают, исходя из запроса заказчика (ICP/CCP/плазмохимическая или антикоррозионная обработка). Позволяет обрабатывать пластины из разных материалов (Si, SiC, GaAs, GaN, сапфир и др.).


MR200/2000/6000_ICP — серия установок для проведения процессов плазмохимического травления слоёв в индуктивно-связанной плазме. Дизайн системы и ее рабочих модулей позволяет настраивать профили травления и получать высокие показатели однородности травления. Применение различных конфигураций рабочих модулей дает возможность проводить травление диэлектрических и металлических слоёв, кремния, а также слоёв группы A3B5.


MR200/2000/6000_CCP — серия установок для проведения процессов плазмохимического травления диэлектрических слоёв в ёмкостно-связанной плазме. Дизайн рабочих модулей разработан для эффективного и однородного травления таких слоев, как: SiO2, Si3N4, SiON.


UTR-150 — однокамерная система для реактивного ионного травления различных материалов и слоев, таких как: диэлектрики, кремний, полимерные слои и маски на пластинах диаметром до 150 мм. Разработана специально для нужд НИОКР.


BIon-E12 – система ионно-лучевого травления для формирования решеток и наклонных профилей (grating) в структурах, для травления магнитных материалов (ячейки MRAM), а также для обработки нелетучих материалов и соединений (Pt, Au, Ir, NiFe, CoFe и др.). В BIon-E12 плазма, генерируемая ионным источником, проходит через решётку, ускоряющую катионы. Электроны из нейтрализатора возвращают луч в нейтральное состояние, сохраняя коллимированный пучок. Частицы бомбардируют образец, физически распыляя материал образца. Благодаря удалённости источника ионов от пластины, нелетучие побочные продукты реакции не влияют на поджиг и состояние плазмы. Свободный от химических ограничений, типичных для реактивного ионного травления, процесс IBE позволяет работать с любыми твёрдыми материалами, включая металлы, магнитные ячейки, сплавы, соединения, диэлектрики и полупроводники. Напряжение и поток луча могут быть независимо изменены для лучшей настройки процесса, при этом угол подложкодержателя может изменяться, что позволяет получать наклонные профили или проводить чистку боковых стенок структур от остатков полимеров и других загрязнений.


BRIon-E12 — система реактивного ионно-лучевого травления для формирования решеток и наклонных профилей (grating) в структурах, для травления магнитных материалов (ячейки MRAM), а также для обработки нелетучих материалов и соединений (Pt, Au, Ir, NiFe, CoFe и др.). Система реактивного ионно-лучевого травления (RIBE) добавляет химические реакции в стандартный IBE-процесс, позволяя достигать более высоких скоростей травления и большей селективности к маске. Держатель пластин может быть наклонён для изменения направления воздействия и достижения заданного угла наклона стенок травления. Поскольку энергия луча и поток ионов могут быть независимо настроены, BRIon-E12 достигает лучшего контроля при формировании рисунка. Система может применяться для травления нестандартных профилей и трудных в обработке материалов. BRIon-E12 уже продемонстрировала способность мирового уровня к травлению наклонных и концентрирующих решёток.


BIon-E8 – система ионно-лучевого травления для формирования решеток и наклонных профилей (grating) в структурах, для травления магнитных материалов (ячейки MRAM), а также для обработки нелетучих материалов и соединений (Pt, Au, Ir, NiFe, CoFe и др.). В системах ионно-лучевого травления плазма, генерируемая ионным источником, проходит через решётку, ускоряющую катионы. Электроны из нейтрализатора возвращают луч в нейтральное состояние, сохраняя коллимированный пучок. Частицы бомбардируют образец, физически распыляя материал образца. Благодаря удалённости источника ионов от пластины, нелетучие побочные продукты реакции не влияют на поджиг и состояние плазмы. Свободный от химических ограничений, типичных для реактивного ионного травления, процесс IBE позволяет работать с любыми твёрдыми материалами, включая металлы, магнитные ячейки, сплавы, соединения, диэлектрики и полупроводники. Напряжение и поток луча могут быть независимо изменены для лучшей настройки процесса, при этом угол подложкодержателя может изменяться, что позволяет получать наклонные профили или проводить очистку боковых стенок структур от остатков полимеров и других загрязнений.


BRIon-E8 — система реактивного ионно-лучевого травления для формирования решеток и наклонных профилей (grating) в структурах, для травления магнитных материалов (ячейки MRAM), а также для обработки нелетучих материалов и соединений (Pt, Au, Ir, NiFe, CoFe и др.). Система реактивного ионно-лучевого травления (RIBE) добавляет химические реакции в стандартный IBE-процесс, позволяя достигать более высоких скоростей травления и большей селективности к маске. Держатель пластин может быть наклонён для изменения направления воздействия и достижения заданного угла наклона стенок травления. Поскольку энергия луча и поток ионов могут быть независимо настроены, BRIon-E8 достигает лучшего контроля при формировании рисунка. Система может быть применена для травления нестандартных профилей и трудных в обработке материалов.
