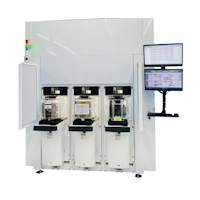
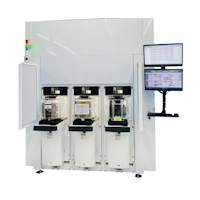
OmniME-12 — кластерная система для проведения процессов травления и пассивации различных стеков тонких пленок. Типовые примеры: структуры ячеек для магнитных туннельных переходов (MTJ-ячейки) магнитной оперативной памяти (МRAM), структуры фазово-переходных сплавов для оперативной памяти с изменением фазового состояния (PCRAM) и резистивных стеков металл-оксид-металл (МОМ). Такие стеки содержат сложные для обработки металлы с нелетучими продуктами реакции, переосаждающимися на боковых стенках структур. Для обработки этих стеков в кластер интегрированы камеры реактивного ионного травления (ICP-RIE), ионно-лучевого травления (IBE) и камера in-situ-пассивации для формирования рисунка ключевых слоёв в устройствах памяти. Комбинируя процессы RIE и IBE, система позволяет минимизировать переосаждение на боковых стенках, характерное для стандартных процессов RIE, и уменьшать критические размеры структур по сравнению с применением только IBE-травления. Модуль in-situ-инкапсуляции дает возможность проводить осаждение защитного слоя после травления без экспозиции пластины на атмосферу, что помогает избежать деградации конечного устройства. Такая кластерная компоновка системы позволяет разрабатывать новые типы устройств памяти.


Система PE12-HM разработана специально для завершающего производственного цикла (BEOL) и проведения процессов плазмохимического травления жёстких TiN-масок. При BEOL-производстве операции травления жёстких масок повторяются несколько раз за цикл изготовления. Применение различных жестких масок и достигаемая высокая селективность процесса травления (< 3 %) позволяют уменьшать критические размеры структур. Система соответствует всем требованиям, устанавливаемым для травления жёстких масок при формировании различных технологических слоев и структур.


Кластерная система PE12-S спроектирована для плазмохимического травления кремния для крупносерийного производства на пластинах диаметром 300 мм. Подходит для процессов травления начального производственного цикла (FEOL) применительно к устройствам логики и памяти. Данная система объединяет решения для формирования структур различных FEOL-слоёв. Система может точно контролировать однородность травления и селективность процессов, что позволяет использовать ее при производстве логических устройств и различных устройств памяти (RAM).


Система PE12-M разработана специально для процессов травления высокоплотных алюминиевых межсоединений для завершающего цикла производства (BEOL), начиная с технологических норм 0.18 мкм. Также находит применение в BEOL-процессах создания алюминиевых контактных площадок.


Система ICP-TC — кластерное оборудование, разработанное для травления поликремниевого затвора на пластинах диаметром 200 мм. Запатентованная конструкция обеспечивает высокую однородность травления (< 5 %) и контроль привнесенной дефектности. Также подходит для травления слоев изоляции (STI), травления вольфрама (W-recess) и формирования специальных разделяющих структур (spacer). Возможна реализация камер для глубокого травления кремния. Кластерная конфигурация значительно увеличивает пропускную способность процессов травления и производства


Система травления металлов ICP-DCM — кластерное оборудование для BEOL-процессов травления различных металлов и слоев алюминия на пластинах диаметром 200 мм. Оптимизированная конструкция этой запатентованной системы предлагает высокую однородность травления (< 8 %) и контроль привнесенной дефектности. При травлении алюминиевых контактных площадок и межсоединений в технологиях с проектными нормами 0.11 мкм позволяет достигать высокой пропускной способности.


ICP-травление широко применяется для формирования микро-/наноструктур и позволяет достигать высоких скоростей травления, селективности и минимального повреждения слоев, вызванным действием плазмы. Благодаря высокой однородности процесса (< 5 %) и возможности контроля профиля, ICP-системы ICP-SC широко применяются в травлении таких материалов, как: Si, SiO2, SiNx, металлов и соединений A3B5. ICP-травление применимо и для формирования различных микро-/наноструктур при производстве систем со сверхбольшой степенью интеграции (VLSI), МЭМС, оптических волноводов и фотоэлектронных устройств.


Система ICP-SCD разработана для процессов глубокого травления кремния для мелкосерийных производств и НИОКР на пластинах Ø 150 мм и 200 мм. Позволяет точно контролировать глубину травления, минимизируя при этом повреждения нижележащих слоёв. Глубокое травление кремния — широко распространённый процесс при производстве микро- и наноустройств. Система ICP-SCD позволяет проводить Bosch-процесс для формирования рисунка в кремнии с высоким аспектным соотношением (HARP). Система обладает высокой пропускной способностью.


ET-SE — установка плазмохимического травления кремния и поликремния. Позволяет варьировать профиль травления от вертикального до конического, обладает хорошими показателями однородности и широким технологическим окном процесса, а также функцией автоматической очистки камеры между пластинами для уменьшения среднего времени между чистками (MTBC).


ET-DE — установка плазмохимического травления диэлектрических слоев. Обладает высокой скоростью травления, хорошими показателями однородности и широким технологическим окном процесса, а также функцией автоматической очистки камеры между пластинами для уменьшения среднего времени между чистками (MTBC).


ET-DSE — установка для глубокого травления кремния. Позволяет варьировать профиль травления от вертикального до конического, обладает хорошими показателями однородности и настройки техпроцесса (< 5 %), высокой скоростью травления слоев Si, широким технологическим окном процесса, а также функцией автоматической очистки камеры между пластинами для уменьшения среднего времени между чистками (MTBC).


ET-ME — кластерная установка плазмохимического травления металлических слоев с камерой антикоррозийной обработки. Позволяет управлять профилем травления, обладает хорошими показателями однородности, широким технологическим окном, а также функцией автоматической очистки камеры между пластинами для уменьшения среднего времени между чистками (MTBC).


ET-PME – установка плазмохимического травления фотошаблонов. Оптимизированная конструкция камеры позволяет точно контролировать получаемые критические размеры (CD), формируемые на фотошаблоне. Подходит для фотошаблонов различных размеров.
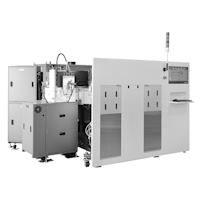
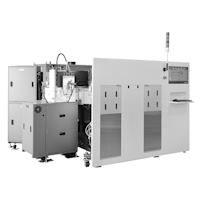
Система Plasma-E+ разработана для проведения плазмохимического травления различных слоев, таких как: оксид и нитрид кремния, фоторезистивные слои и другие полимерные материалы, Si, SiC, поликремний, металлы. Может применяться при производстве интегральных схем, МЭМС, силовой электроники, а также при работе с полупроводниковыми соединениями группы А3В5. Конфигурация процессных модулей зависит от типа необходимого процесса травления, её выбирают, исходя из запроса заказчика (ICP/CCP/плазмохимическая или антикоррозионная обработка). Позволяет обрабатывать пластины из разных материалов (Si, SiC, GaAs, GaN, сапфир и др.).


MR200/2000/6000_ICP — серия установок для проведения процессов плазмохимического травления слоёв в индуктивно-связанной плазме. Дизайн системы и ее рабочих модулей позволяет настраивать профили травления и получать высокие показатели однородности травления. Применение различных конфигураций рабочих модулей дает возможность проводить травление диэлектрических и металлических слоёв, кремния, а также слоёв группы A3B5.


MR200/2000/6000_CCP — серия установок для проведения процессов плазмохимического травления диэлектрических слоёв в ёмкостно-связанной плазме. Дизайн рабочих модулей разработан для эффективного и однородного травления таких слоев, как: SiO2, Si3N4, SiON.


UTR-150 — однокамерная система для реактивного ионного травления различных материалов и слоев, таких как: диэлектрики, кремний, полимерные слои и маски на пластинах диаметром до 150 мм. Разработана специально для нужд НИОКР.


BIon-E12 – система ионно-лучевого травления для формирования решеток и наклонных профилей (grating) в структурах, для травления магнитных материалов (ячейки MRAM), а также для обработки нелетучих материалов и соединений (Pt, Au, Ir, NiFe, CoFe и др.). В BIon-E12 плазма, генерируемая ионным источником, проходит через решётку, ускоряющую катионы. Электроны из нейтрализатора возвращают луч в нейтральное состояние, сохраняя коллимированный пучок. Частицы бомбардируют образец, физически распыляя материал образца. Благодаря удалённости источника ионов от пластины, нелетучие побочные продукты реакции не влияют на поджиг и состояние плазмы. Свободный от химических ограничений, типичных для реактивного ионного травления, процесс IBE позволяет работать с любыми твёрдыми материалами, включая металлы, магнитные ячейки, сплавы, соединения, диэлектрики и полупроводники. Напряжение и поток луча могут быть независимо изменены для лучшей настройки процесса, при этом угол подложкодержателя может изменяться, что позволяет получать наклонные профили или проводить чистку боковых стенок структур от остатков полимеров и других загрязнений.


BRIon-E12 — система реактивного ионно-лучевого травления для формирования решеток и наклонных профилей (grating) в структурах, для травления магнитных материалов (ячейки MRAM), а также для обработки нелетучих материалов и соединений (Pt, Au, Ir, NiFe, CoFe и др.). Система реактивного ионно-лучевого травления (RIBE) добавляет химические реакции в стандартный IBE-процесс, позволяя достигать более высоких скоростей травления и большей селективности к маске. Держатель пластин может быть наклонён для изменения направления воздействия и достижения заданного угла наклона стенок травления. Поскольку энергия луча и поток ионов могут быть независимо настроены, BRIon-E12 достигает лучшего контроля при формировании рисунка. Система может применяться для травления нестандартных профилей и трудных в обработке материалов. BRIon-E12 уже продемонстрировала способность мирового уровня к травлению наклонных и концентрирующих решёток.


BIon-E8 – система ионно-лучевого травления для формирования решеток и наклонных профилей (grating) в структурах, для травления магнитных материалов (ячейки MRAM), а также для обработки нелетучих материалов и соединений (Pt, Au, Ir, NiFe, CoFe и др.). В системах ионно-лучевого травления плазма, генерируемая ионным источником, проходит через решётку, ускоряющую катионы. Электроны из нейтрализатора возвращают луч в нейтральное состояние, сохраняя коллимированный пучок. Частицы бомбардируют образец, физически распыляя материал образца. Благодаря удалённости источника ионов от пластины, нелетучие побочные продукты реакции не влияют на поджиг и состояние плазмы. Свободный от химических ограничений, типичных для реактивного ионного травления, процесс IBE позволяет работать с любыми твёрдыми материалами, включая металлы, магнитные ячейки, сплавы, соединения, диэлектрики и полупроводники. Напряжение и поток луча могут быть независимо изменены для лучшей настройки процесса, при этом угол подложкодержателя может изменяться, что позволяет получать наклонные профили или проводить очистку боковых стенок структур от остатков полимеров и других загрязнений.


BRIon-E8 — система реактивного ионно-лучевого травления для формирования решеток и наклонных профилей (grating) в структурах, для травления магнитных материалов (ячейки MRAM), а также для обработки нелетучих материалов и соединений (Pt, Au, Ir, NiFe, CoFe и др.). Система реактивного ионно-лучевого травления (RIBE) добавляет химические реакции в стандартный IBE-процесс, позволяя достигать более высоких скоростей травления и большей селективности к маске. Держатель пластин может быть наклонён для изменения направления воздействия и достижения заданного угла наклона стенок травления. Поскольку энергия луча и поток ионов могут быть независимо настроены, BRIon-E8 достигает лучшего контроля при формировании рисунка. Система может быть применена для травления нестандартных профилей и трудных в обработке материалов.
